Intel 在進行企業轉型的 IDM 2.0 策略除了積極發展製程技術以外,也宣布投入晶圓代工服務領域,與台積電、三星等爭取晶圓代工訂單,但同時亦透過先進封裝技術可進行跨晶圓廠晶粒的混合封裝; Intel 在 2023 年 5 月 18 日展示當前旗下的先進封裝技術,希冀能吸引更多代工客戶選擇 Intel 服務,同時也進一步宣布開放客戶僅使用 Intel 的部分服務,諸如客戶可選擇由其它晶圓代工廠生產晶粒,再採用 Intel 的封裝與測試,等同提供客戶更多的系統晶片製造彈性。 Intel 強調目前與全球 10 大晶片封裝客戶當中的七家洽談,並已取得 Cisco 與亞馬遜 AWS 的青睞。
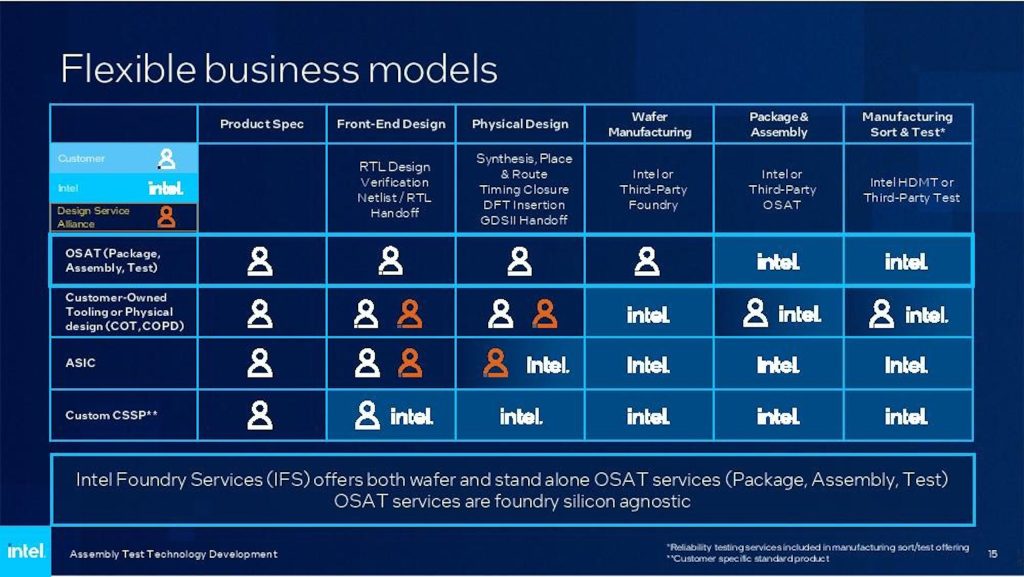
▲ Intel 強調提供彈性的代工服務,客戶不一定要完全使用 Intel 的晶圓製造與封裝配套組合
為了強化代工業務, Intel 除了晶圓代工業務以外,也開放封裝與測試服務供客戶使用,同時客戶不一定要採用 Intel 一條龍的業務模式,可選擇部分使用,諸如僅使用封裝與測試的部分,但晶圓委由非 Intel 生產。
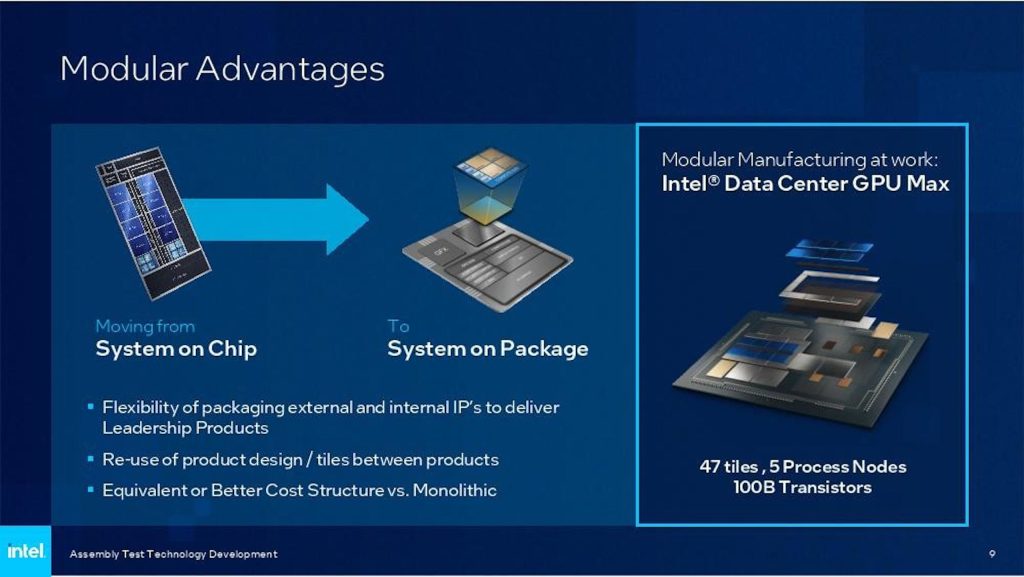
▲ Ponte Vecchio 同時運用 EMIB 2.5D 封裝與 Foveros 3D 封裝
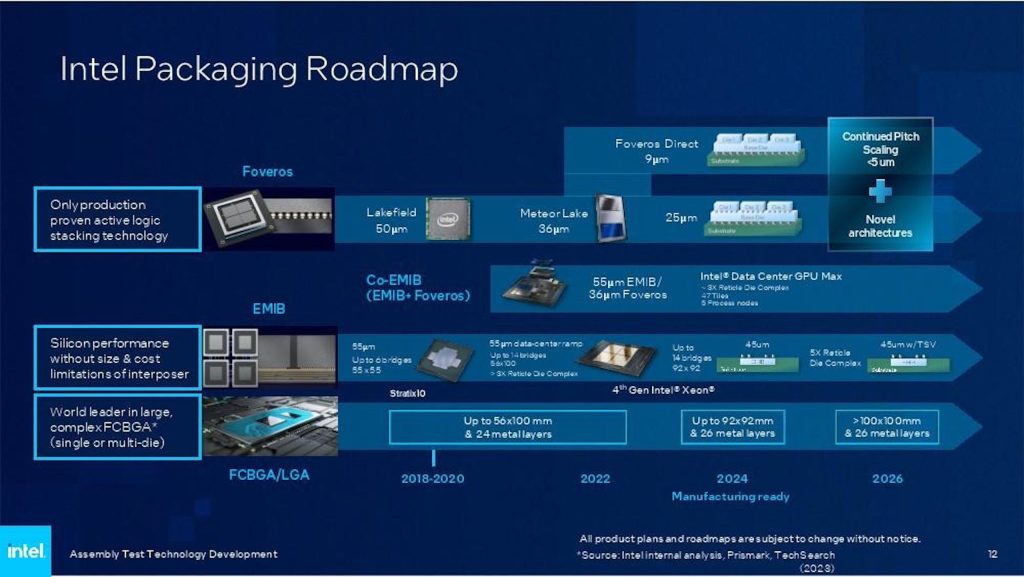
▲ EMIB 與 Foveros 兩大封裝技術也將依循藍圖持續發展
Intel 以旗下產品 GPU Max ( Ponte Vecchio )說明當前 Intel 在封裝技術上的優勢, Intel 的 GPU Max 是以跨 Intel 與台積電晶粒的小晶片架構產物,透過 Intel 的 EMIB 2.5D 封裝與 Foveros 3D 封裝構成,其中 EMIB 2.5D 封裝主要合併運算相關晶粒, Foveros 3D 封裝則將 I/O 、 L2 快取、 I/O 控制器堆疊在運算晶粒上方。 EMIB 與 Foveros 也將持續進行發展,同時也維持可併用的特質。
Intel 將朝向玻璃核心基板、共同封裝光學元件技術邁進
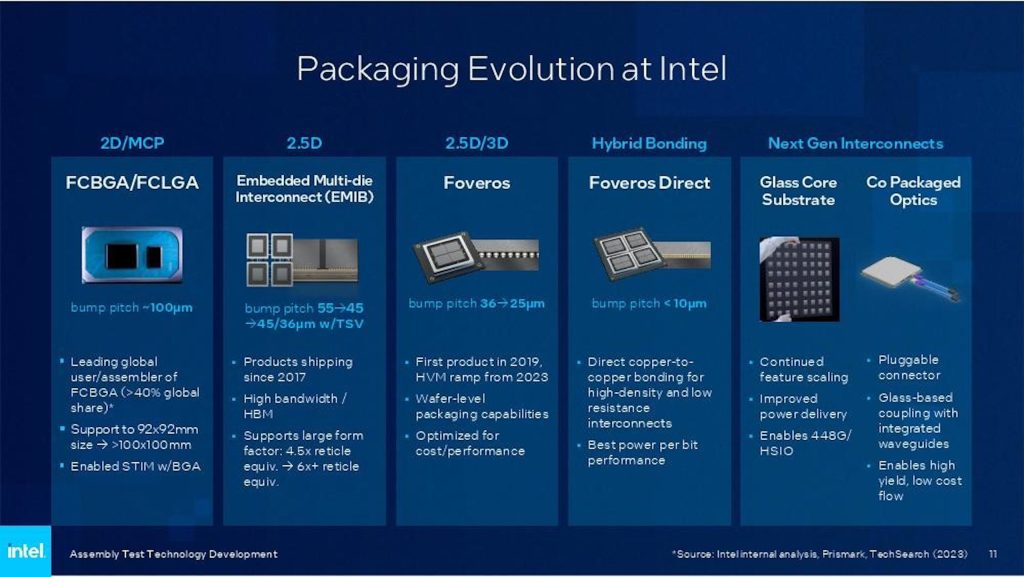
▲ Intel 有意轉換到玻璃材質晶片基板
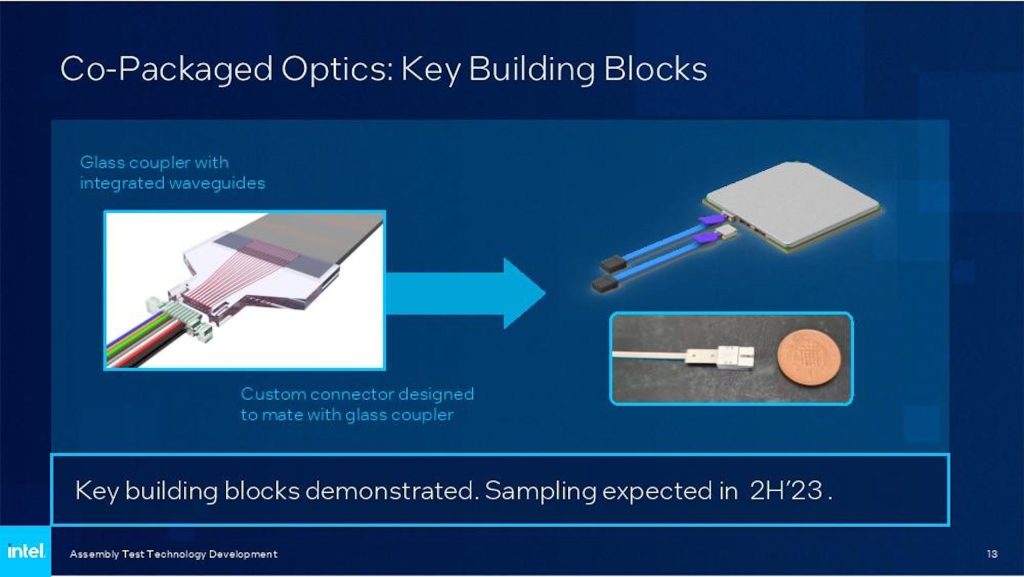
▲ Intel 展示 Co-Packaged Optics 共同封裝光學元件技術,使晶片之間具備更高的頻寬
在此次技術說明會介紹的未來封裝技術展望當中, Intel 提到有亦將晶片基板轉換到玻璃材質,將有助提升晶片基板強度並提高能源傳導效率;另一項技術則是 Co-Packaged Optics 共同封裝光學元件技術,該技術利用玻璃基底的光學傳輸方式提升相互溝通的頻寬,並具備可插拔的能力,預計在 2023 年第二季提供樣品。












暂无评论内容